上次我们就聊到硅晶柱成长制程,那么之后是晶柱切片后处理,将晶柱做裁切与检测,裁切掉头尾的晶棒进行外径研磨、切片等步骤,所以我们来看看晶柱是如何制作成一片晶圆。
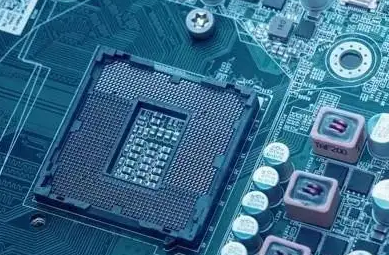
1、切片(Slicing)
长久以来经援切片都是采用内径锯,其锯片是一环状薄叶片,内径边缘镶有钻石颗粒,晶棒在切片前预先黏贴一石墨板,不仅有利于切片的夹持,更可以避免在最后切断阶段时锯片离开晶棒所造的破裂。
切片晶圆的厚度、弓形度(bow)及挠屈度( warp)等特性为制程管制要点。影响品圆质量的因素除了切割机台本身的稳定度与设计外,锯片的张力状况及钻石锐利度的保持都有很大的影响。
2、圆边(Edge Polishing)
刚切好的晶圆,其边缘垂直于切割平面为锐利的直角,由于硅单晶硬脆的材料特性,此角极易崩裂,不但影响晶圆强度,更为制程中污染微粒的来源,且在后续的半导体制成中,未经处理的晶圆边缘也为影响光组与磊晶层之厚度,固须以计算机数值化机台自动修整切片晶圆的边缘形状与外径尺寸。
3、研磨(Lapping)
研磨的目的在于除去切割或轮磨所造成的锯痕或表面破坏层,同时使晶圆表面达到可进行抛光处理的平坦度。
4、蚀刻(Etching)
晶圆经前述加工制程后,表面因加工应力而形成一层损伤层(( damagedlayer),在抛光之前必须以化学蚀刻的方式予以去除,蚀刻液可分为酸性与碱性两种。
5、去疵(Gettering)
利用喷砂法将晶圆上的瑕疵与缺陷赶到下半层,以利往后的IC制程。
6、抛光(Polishing)
晶圆的抛光,依制程可区分为边缘抛光与表面抛光两种。
7、边缘抛光(Edge Polishing)
边缘抛光的主要目的在于降低微粒(particle)附着于晶圆的可能性,并使晶圆具备较佳的机械强度,但需要的设备昂贵且技术要求高,除非客户要求,否则不建议进行本制程。
8、表面抛光(Surface Polishing)
表面抛光是晶圆加工处理的最后一道步骤,移除晶圆表面厚度约10-20微米,其目的在改善前述制程中遗留下的微缺陷,并取得局部平坦度的极佳化。以满足IC制程的要求。基本上本制程为化学-机械的反应机制,由研磨剂中的NaOH=KOH、NH4OH腐蚀晶圆的最表层,由机械摩擦作用提供腐蚀的动力来源。

 扫码关注
扫码关注