1.定义
晶圆键合技术是指通过化学和物理作用将两块已镜面抛光的同质或异质的晶片紧密地结合起来,晶片接合后,界面的原子受到外力的作用而产生反应形成共价键结合成一体,并使接合界面达到特定的键合强度。
英文 Wafer Bonding Technology
2.分类


3 键合条件
影响键合质量的内在因素是晶片表面的化学吸附状态、平整度及粗糙度;外在因素主要是键合的温度和时间。
通常还需要加压来克服表面起伏与增加表面原子间的成键密度,来达到提高键合强度的目的。
决定键合成功与否的基本条件:
(1)几何条件:利用键合技术可以有效解诀晶格失配的问题,要保证两个键合晶片的表面平整度与弹性模量的差异要小。
(2)机械条件:键合所需的表面需要非常平滑,表面的粗糙度要求达到2nm以上,配合化学机械研磨(C雔}任)实现。
(3)物理条件:由于磊晶或长晶的过程往往会有一些缺陷,如:晶界(grainboundaries)�大、晶格错位(dislocation)?双尖峰(spikes?等,这些也需使用CMP的方式去除。
(4)化学条件:两个欲键合表面的洁净度非常重要,键合时需注意去除表面金属、有机物等杂质。
(5)能量条件:在热处理的过程中,温度可能会造成表面残余物质的化学反应,键合过程中引入热应力导致形变等对器件不利的结果。
为了达到良好的键合质量,通常需要对欲键合的晶片进行前期准备,主要通过表面处理、预键合及热处理三个过程。进行表面处理之前,
4.键合界面的性质
(1)键合界面的位错和空洞。
除了硅硅直接键合这种同质材料键合之外,大部分都是通过异质材料进行键合。而由于两个键合的材料不同,晶片之间必然存在着热失配及晶格失配等问题。键合界面将会产生应力,为了应力弛豫,界面处会形成一定的位错,会严重影响器件的性能。此外,晶片表面会有一定的杂质、多孔层结构和空洞。这些杂质和多孔层结构的产生可能是由于表面未清洗洁净及界面附近的原子重组造成的,空洞是晶片在退火时产生的气泡引起的。
(2)键合界面的电学和光学特性。
键合晶片的界面状态会影响晶片的电学和光学性质,通过I-籚特性及PL谱等测试手段来分析界面处的键合情况,有助于更好的了解界面的性质变化,从而改进方法来提高界面的电学和光学性能。
(3)键合界面的表面悬挂键和键合能。
对于晶片来说,晶片内部与晶片表面的原子有不同的排列方式。当表面某处的原子排列出现中断时,表面处就会产生额外的能量此时中断处附近的原子如果仍以内部结构的形式排列,系统的自由能会明显增加。为了恢复稳定的排列方式,表面处的原子会进行一定的调整来降低附加的自由能。
实现调整的方式主要有两种:通过晶片表面自行调整和借由外界条件调整。
对于自行调整方式,由于晶片内部受力与晶片表面受力的情况显著不同,表面的晶格常数会随之发生改变。改变后晶片表面的原子与内部原子的排列形成不同的排列方式。如重构、台阶化等。以这种方式排列之后表面会形成本征表面态。
通过外界条件的调整方式,晶片表面原子之间存在不饱和键,易吸附外来的杂质。吸附杂质的同时还进行电子交换,原有的表面太发生变化形成非本征表面态。通过以上两种调整方式都可以达到减低表面能的目的,从而使晶片内外系统达到稳定。
晶片的表面悬挂键越多,表面能越大,键合时两个晶片之间的原子越容易相互作用。而键合界面处随着原子的不断相互作用形成越来越多的共价键,键合晶片的界面越牢固,键合强度越大。
(4)键合界面的键合能公式表示为:

其中,x表示界面的表面能,n为成键密度,Eb为每根键的能量。同质材料的键合能为表面能的二倍,即2 }1;异质材料的键合能为键合晶片的平均表面能。
二、晶圆键合设备
1.晶圆键合工艺
先将晶圆装载到FOUP中,并由中央机械手臂对晶圆逐片检测——(FOUP是指front-opening Unified Pod,即前开腔体)
表面预处理
待键合晶圆精密对准
放置于后续键合所需的固定传输夹具中
在键合腔体中对准后进行键合
键合室实时监测温度、键合压力及气氛
对键合后的晶圆进行冷却
键合后质量检测

2.表面预处理——用于表面改性或清洗
(1)常见预处理
干法预处理——等离子体预处理,在封闭腔体内采用真空等离子体技术或常压等离子体技术实现
湿法预处理——在旋转的晶圆表面上方,通过前后移动的机械装置喷洒化学试剂或去离子水实现
酸蒸汽清洗——衬底暴露于一种还原性的酸蒸汽中以去除表面氧化层
(2)表面预处理——湿法化学处理
硅硅键合或熔融键合中常用——亲水性处理:经过亲水性处理后,晶圆表面吸附的【OH】基会与其他晶圆表面的悬挂键进行结合,这些基会吸附晶圆表面水分子形成角水基,当两个经亲水性处理的晶圆的距离接近角水基中存在的偶极矩的作用范围时,两晶圆会在范德华力作用下相互接触并键合到一起。当晶圆结合后,室温下一种称作四聚物的环形物
物质会在接触界面形成,即所谓的键合波纹,可通过红外摄像仪观察到。
环形波纹产生的过程为:首先,两晶圆相互悬浮直至形成点接触,启动键合并穿透表面的静电斥力,在后续键合过程中,接触面附近的空气呈环形波纹被挤压排除;当晶圆在范德华力作用下完全接触后,室温下晶圆接触界面处就会形成环四聚物的环形物质。
亲水性处理的工艺:
1)晶圆在传统湿法槽中采用NH4OH:H202:H2O混合液(1:1:10)在55℃下浸泡3分钟;
2)采用键合工艺平台中的清洗模块:在室温下使用浓度1%-4%的NH4OH。
通常需要两步:首先喷洒NH4OH
然后使用DI水兆声清洗并随后甩干。
在键合平台中亲水性处理的好处:既可以将晶圆表面变为亲水性,又可以避免由于范德华力作用将环境中的杂质颗粒吸附表面带来的影响。
颗粒检测工艺——维护清洗工艺模块的关键(晶圆级键合工艺完成后,键合面就成了埋层界面,所有表面颗粒或污染物都会残留在键合界面内,会对芯片的良率及器件性能改造造成潜在的影响)
方式:对工艺前后晶圆表面颗粒数进行对比。
设备:KLA Tencor SP2颗粒检测工具
(3)表面预处理——等离子体化
用途:针对硅-硅熔融键合用于活化硅表面;
在Cu-Cu扩散键合的预备阶段利用其刻蚀特性进行金属表面清洁。
工艺:极低真空应用式、电容耦合反应离子刻蚀式(RIE)、常压等离子体源式以及下游反应器等
优势:
可提高范德华力的结合强度,从两倍到一个数量级
使范德华键合力向Si-O-Si共价键烷键键合力的转化能力显著提升——缩短后续退火时间,降低退火温度到450℃以下
等离子体系统的检测:有、无暴露冲洗两种情况下的颗粒检测
供应商:SUSS MicroTec 、EVGroup、三菱、Silicon Genesis(SiGen)等工艺设备商均可提供用于晶圆级键合的等离子体活化系统。
(4)表面预处理——蒸汽清洗
Cu-Cu晶圆级键合工艺条件下,如果不采用表面预处理工艺,那么铜表面将不可避免发生氧化现象,从而使得Cu的自扩散速率降低几个数量级,对键合产生不良影响。
酸蒸汽处理可以避免晶圆浸没在液体中,可以将试剂对叠层晶圆上的钝化层、键合层、绝缘层受到的刻蚀影响降到最低甚至是完全避免。(甲酸最优)
设备:SUSS MicroTec 的C4NP型模具传输设备和芯片键合设备。

 扫码关注
扫码关注











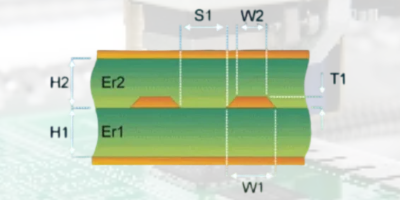













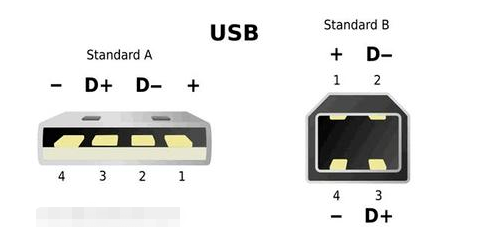


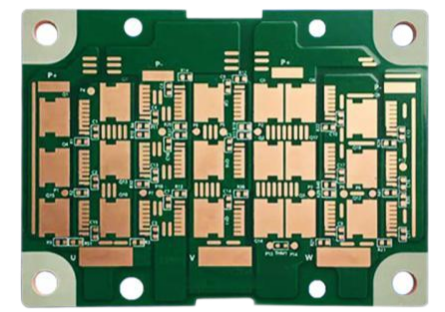





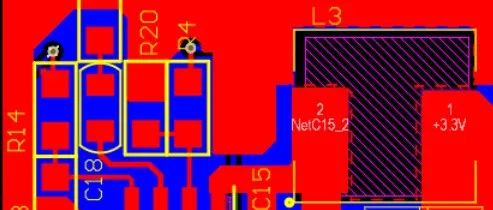



![电子设计:离散傅里叶变换的性质[学以致用系列课程之数字信号处理]](https://api.fanyedu.com/uploads/image/f4/7b653b5cf6c5b53ce0972f49b55379.png)


































