离子注入工艺参数
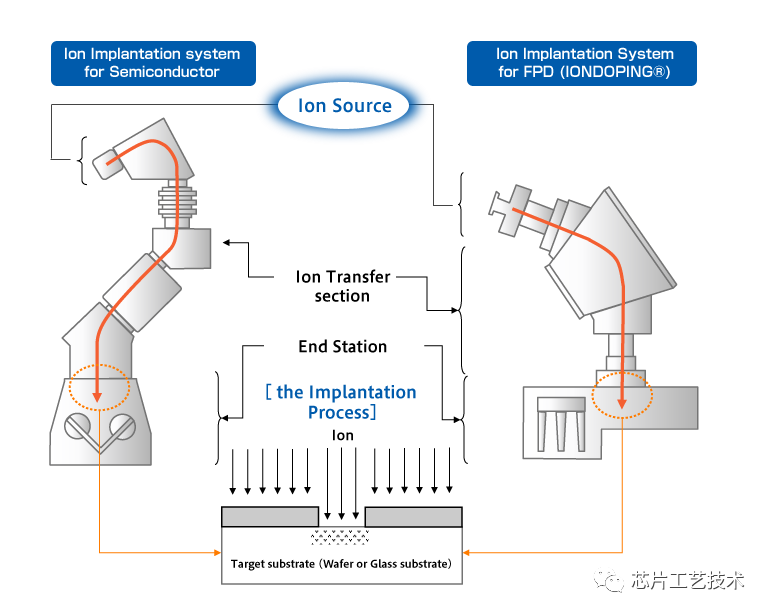
00

离子注入就像上图一样,把离子砸到晶圆中。涉及到使用的力度、数量、角度,砸进去的深度等。
或许大家看注入机设备规格的时候,会注意到在讨论能量范围的时候,KeV注明是单电荷。
我们知道扩散源以原子的形态被打入等离子发生室内,其核外电子被电离游走掉,有的原子被电离掉一个电子、有的两个、甚至3个,电离出来的电阻越多,需要的能力越大。因此在一锅Plasma中,一价的离子是最多的。
一般的离子注入机都有电荷的能力,原理大家可以想象高中学的什么库仑作用力吧,带的电荷不同,电磁场中获得的动量不同。设备可以选择工艺需要的价态离子进行注入。
如果单电荷可以做到400KeV的能量的话,对应3 离子可以做到1200KeV,可以直接倍速关系。

离子注入的关键工艺是如何控制掺杂剂量、注入深度等。


例如上图As注入到Si晶格中,As离子进入硅之后,不断和硅原子碰撞,逐步损失能量,最后停下来,停下来的位置是随机的,大部分不在晶格上的,也就没有电活性。
1963年Lindhard,Scharff 和 Schiott首先确立了注入离子在靶内的分布理论。简称LSS理论。
LSS理论就是讨论离子是靶内是如何停下来的,靠靶的原子核或者核外电子。再给他们二位起个名字叫阻止本领。

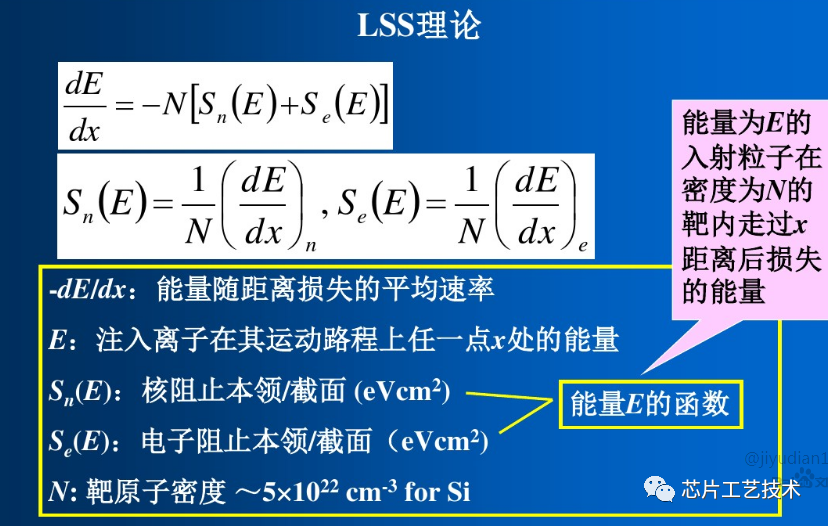

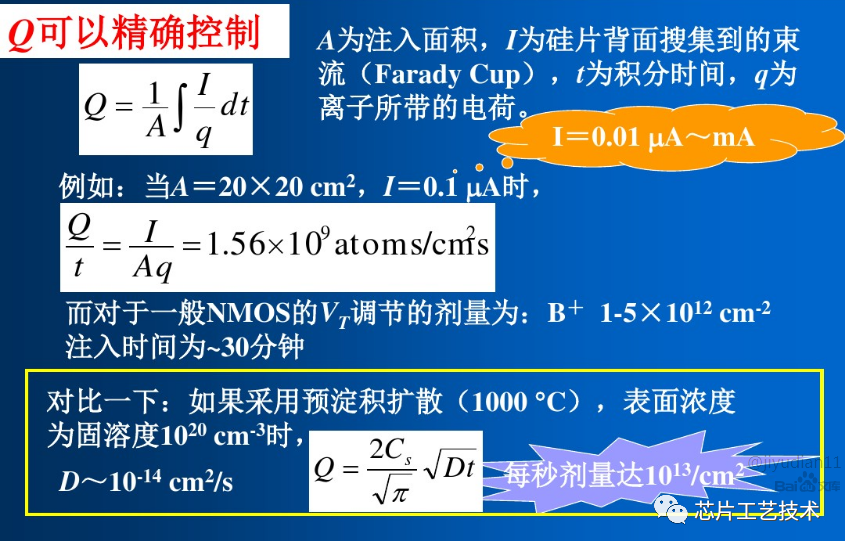
https://wenku.baidu.com/view/5935cde8970590c69ec3d5bbfd0a79563c1ed43c.html更详细的知识可以看文库文件。
如果我们只知道需要掺杂的剂量,和离子能量,如何计算注入离子在靶材中的浓度和深度
例如一个140KeV的B 离子,注入150mm的6寸硅片上,注入剂量Q=5*1014/cm2,衬底浓度2*1016/cm3.
估算注入离子的投影射程,标准偏差、峰值浓度、结深。
如果注入时间1分钟,估算所需束流。



另外注入到其他衬底材料的时候,同样的离子,和硅单晶比的话,晶格常数越大的,越容易注入,晶格常数越小,越难注入。就好比往鸡蛋篮子里面丢沙子一样的道理,缝隙越大越容易塞进去。

不过不同注入能力的离子注入设备,价格也相差不少呢,比如第三代半导体这种,也要上千W,一台设备也要占地大几十平的房间,真是烧钱的老母鸡,就是不知道能不能下金蛋。

 扫码关注
扫码关注