离子注入作为半导体常用的掺杂手段,具有热扩散掺杂技术无法比拟的优势。列表对比

掺杂原子被动打进到基板的晶体内部,但是它是被硬塞进去的,不是一个热平衡下的过程,杂质一般也不出在晶格点阵上,且离子轨迹附近产生很多缺陷。如下图,

但是离子注入之后也是需要二次退火的,退火的目的一是去除缺陷,二是让掺杂的原子能够进入到晶格里面去,让其处于激活状态。感兴趣的可以查阅半导体书本学习,推荐一本卡哇伊的半导体书,日本人画的,估计是一位热爱画漫画的微电子专业的学生画的,萌妹子+知识点画的很生动。
如何做好离子注入,可以通过以下公式计算得到。
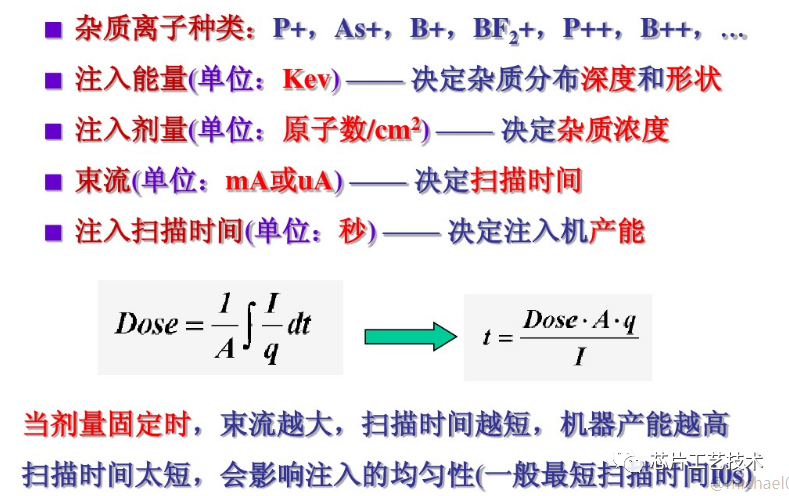

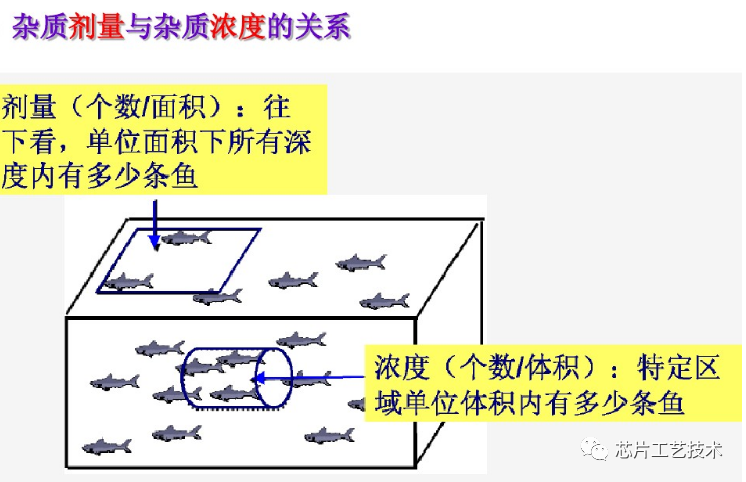
离子注入工艺仿真
公式计算有点伤脑细胞啊,大家可以学习一下
《Silvaco TCAD工艺仿真离子注入、扩散、淀积和刻蚀》这本课
需要的同学可以来要PPT讲义。
TCAD有专门针对工艺仿真的功能。减少了实际试验的盲目。

上图是注入的参数选择窗口(Linux系统版本采用这个窗口)


例如我们模拟不同硼离子注入角度的效果
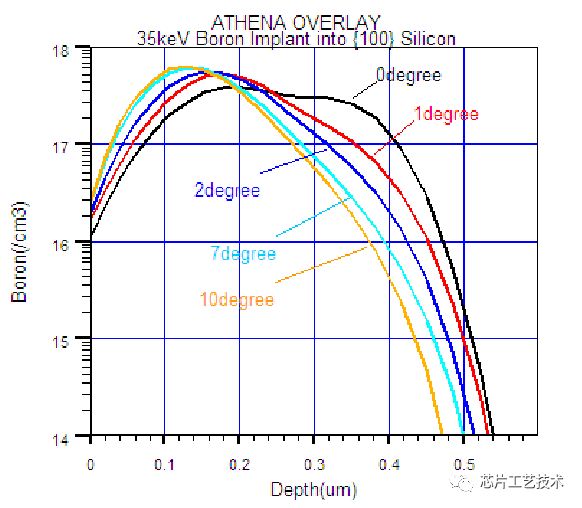
如上图,在晶向(110)的硅片上注入B离子,角度不同得到的注入深度对应的离子浓度不同。在这里我们就可以清楚的得到,离子在哪个深度的浓度最大。
附仿真代码:
go athena
line x loc = 0.0 spacing=0.02
line x loc = 0.5 spacing=0.02
line y loc = 0 spacing = 0.02
line y loc = 0.6 spacing = 0.05
个人备注哈:#后面的都是语句解释,不会运行。解释一下line语句,Line是表示定义网格,进行二位的定义,Loc是Location的简写,spacing是loc处临近网格的间距,二者默认单位都是um。其实就是定义一个仿真范围,而且spacing越小仿真的约细。
init
structure outfile=origin_STR.str
go athena
init infile=origin_STR.str
implant boron energy=35 dose=1.e13 tilt=0 rotation=0 print.mom
save outfile=titl_0.str
init infile=origin_STR.str
implant boron energy=35 dose=1.e13 tilt=1 rotation=0 print.mom
save outfile=titl_1.str
go athena
init infile=origin_STR.str
implant boron energy=35 dose=1.e13 tilt=2 rotation=0 print.mom
save outfile=titl_2.str
go athena
init infile=origin_STR.str
implant boron energy=35 dose=1.e13 tilt=7 rotation=0 print.mom
save outfile=titl_7.str
go athena
init infile=origin_STR.str
implant boron energy=35 dose=1.e13 tilt=10 rotation=0 print.mom
save outfile=titl_10.str
tonyplot -overlay titl_*.str
go athena
思考:如果注入量Dose=1*1015ions/cm2;注入离子选用N,基板采用砷化镓,求深度0.1um~1.5um处的离子注入浓度。注入角度0~7°,离子能量根据选用300Kev,选用2价N 。

 扫码关注
扫码关注